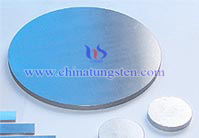
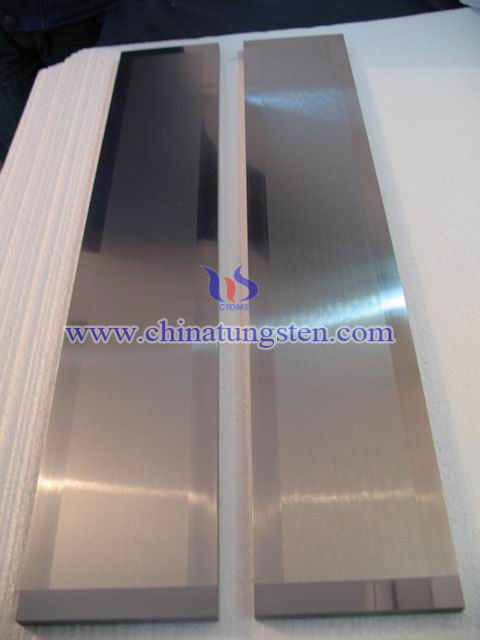
マグネトロンモリブデンスパッタリングターゲット

ポイント5560℃沸騰99.95%の純度のモリブデンスパッタリングターゲットと密度10.2グラム/ ccで、2610℃の融点、。タイプは、長方形のマグネトロンスパッタリングマンモグラフィ、マンモグラフィ及びモリブデンターゲット管スパッタリング円筒マグネトロンスパッタリングマグネトロンを含みます。モリブデンスパッタリングターゲット、高強度、高温、耐摩耗性、優れた性能の腐食品種を有します。モリブデンスパッタリングターゲットは、主に、フラットパネルディスプレイ、薄膜太陽電池の電極と配線材料や半導体材料のバリア層で使用されています。
マグネトロンスパッタリングマンモグラフィ飛行基板の処理において、電界Eの電子を指すが、アルゴンイオン化正イオンと新たな電子を生成するためにアルゴン原子と衝突働く、新たな電子フライイルスパッタリングターゲットが発生するようにシート、Arイオンは、陰極のターゲットに向かって電界で加速され、ターゲット表面の高エネルギーの衝撃。
発生した二次電子は、電場と磁場は呼ば、Bドリフトの意味の範囲内でE(電界)×向き(磁界)が生成される一方、スパッタ粒子は、中性のターゲット原子または分子が、基板上に堆積された薄膜を形成E×Bドリフトは、その軌道はサイクロイドマグネトロンスパッタ、マグネトロンスパッタリングに似ています。環状磁場場合、ターゲット表面のおおよそのサイクロイド円運動の形で電子は、それらの動きだけでなく、非常に長いパスであり、ターゲット表面近傍、及びこの領域にプラズマ領域内にイオンを大量に結合していますAR高い堆積速度を達成するために、ターゲットに衝突します。衝突の数を増加させると、二次電子のエネルギーが離れターゲット表面と、基板上に最終的な堆積の電界Eの役割から移動する、消費します。電子エネルギーが低いため、基板へのエネルギー移動は、低い基板温度で得られ、非常に小さいです。
マンモグラフィは、マグネトロンスパッタリングプロセスは粒子の入射目標を衝突です。入射粒子がターゲット複雑なプロセスで散乱受ける、ターゲット原子の衝突は、運動量の一部は、ターゲット原子、このターゲット原子と原子の衝突や他のターゲット、カスケードプロセスの形成を通過します。このカスケードプロセスでは、特定のターゲット原子表面付近に十分な勢い外側への移動を取得するには、ターゲットがスパッタされるアウト残します。
マグネトロンスパッタリングマンモグラフィの利用は、生産プロセスコスト会計のエンジニアリングおよびマグネトロンスパッタ源のパラメータになることがあります。 2012年の時点では、実用的な意義の理論的に算出された近似ターゲット利用スパッタリング議論からマグネトロンスパッタリングターゲットの使用率やシステム専門研究報告のために見ていません。静的直冷長方形の平面ターゲットのため、20%以上〜30%の利用を対象と(MAX)のデータは、冷却水の目標と直接接触して、ターゲットとターゲットと磁石との間に相対運動をしない、すなわち、よりため推定値。異なる筒状の回転磁界が最も有名で広く70%以上の最高の利用率の目標を容疑者した産業で使用される標的れる動的対象の形態が、十分の欠如を見つける、ターゲット利用率を向上させるためにデータや理論的な証拠。矩形平面、円形フラットと円筒管:観点から一般的なマグネトロンスパッタリングモリブデンターゲット形状は、3つのタイプがあります。
あなたが私たちのモリブデンスパッタリングターゲットに興味を持っている場合は、ご連絡ください:
メール: sales@chinatungsten.com sales@xiamentungsten.com
電話: +86 592 5129696 / 86 592 5129595
ファックス: +86 592 5129797
| モリブデン製品 | モリブデン線 | ブラックモリブデン線 | ホワイトモリブデン線 | モリブデン、ジルコニウム、ハフニウム炭素合金 モリブデンボート | モリブデン - 銅合金 | モリブデンディスク | モリブデン電極 | モリブデンバー | モリブデン線スプレー モリブデン箔 | モリブデン、ハフニウム炭素合金 | モリブデン針 | モリブデンプレート | モリブデンロッド | 鉬片 モリブデンスパッタリングターゲット |カーボンチタンジルコニウムモリブデン合金 | モリブデン、ジルコニウム - チタン合金 |

 sales@chinatungsten.com;
sales@chinatungsten.com;